炒股就看金麒麟分析師研報,權威,專業,及時,全面,助您挖掘潛力主題機會!
IT之家 6 月 27 日消息,韓國先驅報於 6 月 25 日發布博文,報道稱 LG Innotek 宣佈開發出全球首個用於高端半導體基板的高價值銅柱(Cu-Post)技術,在保持性能的前提下,讓智能手機基板尺寸最高可減少 20%,為更輕薄、高性能手機的發展邁出重要一步。

隨着全球智能手機製造商競相提升設備性能並最小化設備厚度,對先進且緊湊的半導體基板技術的需求急劇增長。
LG Innotek 預測這一趨勢,於 2021 年開始研發下一代 Cu-Post 技術。與傳統的直接使用焊球連接基板和主板的方法不同,Cu-Post 技術利用銅柱來減小焊球的間距和大小。
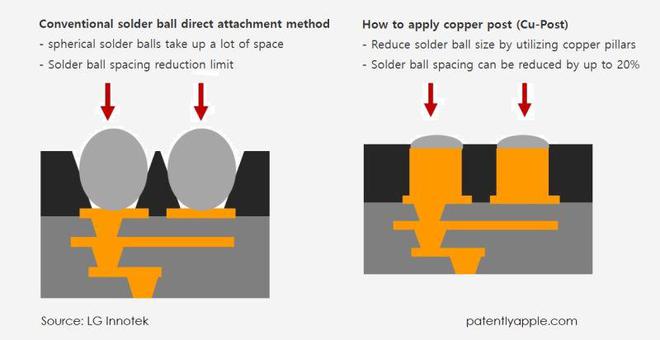
這項技術不僅減少了基板尺寸,還支持更密集的電路佈局,從而在不影響性能的前提下提高集成度。LG Innotek 表示,應用 Cu-Post 技術後,保持相同的性能水平的情況下,半導體基板的尺寸最高可減小 20%。
這項技術還顯著改善了設備的散熱性能。銅的導熱性是傳統焊球的七倍以上,能夠更快地從半導體封裝中散熱。

該公司已經制定了雄心勃勃的計劃,到 2030 年將半導體組件業務 —— 以高端基板和汽車應用處理器模塊為核心 —— 發展成為年銷售額達 3 萬億韓元(IT之家注:現匯率約合 158.55 億元人民幣)的板塊。
海量資訊、精準解讀,盡在新浪財經APP