在功率半導體材料的進化譜系中,硅(Si)走到了盡頭,碳化硅(SiC)正當紅,而氮化鎵(GaN)則在高頻輕載領域攻城略地。然而,行業對更好的材料的追求是無止盡的。
11月初,日本Patentix株式會社宣佈全球首次利用FZ法成功生長出金紅石型二氧化鍺(r-GeO2)塊體晶體——尺寸達到5毫米。這塊小小的晶體,帶隙高達4.68 eV——遠超碳化硅(3.3 eV)和氮化鎵(3.4 eV),並且理論上可同時實現p型與n型摻雜。
這一突破,再次將超寬禁帶(UWBG)氧化物材料體系推向前台。隨着電動汽車(EV)的普及、AI 數據中心的能耗增長、減碳與節能需求的增強,以及車載功率模塊小型化趨勢的到來,超寬禁帶半導體的商業化正受到高度期待。而氧化物,如GeO2和Ga₂O₃,正被視為實現更高耐壓、更高功率、更高效率的下一代功率半導體器件的重要候選材料。
二氧化鍺:UWBG賽道新黑馬?
在超寬禁帶(Ultra-Wide Bandgap, UWBG)半導體領域,除了廣為人知的氧化鎵(Ga₂O₃),二氧化鍺(GeO2)正迅速嶄露頭角,成為新一代功率半導體的競爭者。
二氧化鍺作為功率半導體的優勢主要有三點:其一,它是具有高功率半導體潛力的超寬帶隙半導體;其二,它適用於常規型GeO2 MOSFET的P型和N型摻雜;其三,它擁有廉價的塊狀晶體和外延層。

二氧化鍺的定位(圖源:Patentix)
二氧化鍺(GeO2)共有五種晶體結構:金紅石型、α-石英型、CaCl2型、α-PbO2型和黃鐵礦型。日本公司Patentix目前取得突破的就是金紅石型二氧化鍺(r-GeO2),r-GeO2具有4.6 eV的巨大帶隙,理論預測其同時具有n型和p型導電特性。因此,它有望應用於下一代高性能常關型MOSFET等領域。
Patentix 株式會社是一家源自立命館大學的初創企業,專注於超寬帶隙(Ultra-Wide Bandgap, UWBG)半導體材料——二氧化鍺(GeO2)的研究開發、製造與銷售。自2022 年12月成立以來,公司累計孖展額已達10.59億日元。
為了最大限度地發揮r-GeO2的潛力,需要實現具有最小晶體缺陷的高質量塊狀襯底。此前該公司曾使用助熔劑法 (Flux Method) 合成塊狀晶體,最大尺寸約為15x2.5x5mm]。為了利用r-GeO2實現功率半導體器件,更高質量和更大尺寸的塊狀晶體是必需的。
此次Patentix以傳統熔劑法合成的r-GeO2塊體晶體作為種晶,Patentix成功實現了全球首例通過FZ法生長的 r-GeO2晶體。如圖 1所示,晶體左側的黑色部分為 FZ 法生長區域,尺寸約為 5 mm。雖然晶體因摻雜添加物而呈現黑色,但其側面可觀察到明顯的晶面(facets),顯示出較高的晶體質量。

圖1:採用FZ法生長的r-GeO₂塊體晶體照片。左側的黑色部分為通過 FZ 法生長的晶體,右側的白色部分為採用熔劑法(Flux 法)合成的種晶。(圖源:Patentix)
通過 X 射線衍射(XRD)對側面晶面進行分析,確認其對應 r-GeO2的 (110) 晶面(見圖 2)。進一步將生長部分研磨成粉末後進行 XRD測試,觀察到 r-GeO2的晶峯;但同時也檢測到三方晶系(trigonal)GeO2的衍射峯,說明生長晶體中仍含有與金紅石型不同的雜相(見圖 3)。

圖2:晶體側面晶面的 X 射線 2θ/θ 衍射圖譜。
(圖源:Patentix)

圖3:將晶體粉末化後獲得的 X 射線 2θ/θ 衍射圖譜。(圖源:Patentix)
該公司接下來的目標是製備出半英寸級的 r-GeO2塊體襯底,更長遠的計劃是,結合半英寸 r-GeO2塊體襯底與Minimal Fab系統,開發出傳統半導體材料無法實現的超高性能功率器件。
除了金紅石型GeO2,另一方面,三角晶系α-石英型GeO2具有6.2 eV的超大帶隙,並表現出壓電性。因此,它有望作為HEMT元件應用於下一代肖特基勢壘二極管以及6G之後的高容量、高速7G通信。
氧化鎵,日本技術積累頗深
接下來讓我們再來看看看從前幾年就開始被業界追捧的氧化鎵(Ga₂O₃),被視為繼SiC與GaN之後最具潛力的高壓功率器件材料。它是一種性能遠超氮化鎵的無機化合物,目前已知晶相多達六種,其中包括α、β、γ等五種穩定相與一個瞬態相κ-Ga₂O₃。其中,β相(β-Ga₂O₃)是熱力學最穩定、研究最深入的晶體結構,也是當下產業化的主角。
β-Ga₂O₃的研究最早可以追溯至日本筑波材料科學研究所(NIMS)與德國柏林 Leibniz 晶體研究所的合作階段。這種材料熔點高達 1793℃,在高溫下其他相都會轉變為 β 型,因此只能通過熔體法獲得單晶。得益於優異的熱穩定性,β-Ga₂O₃可採用與硅晶圓相似的 直拉法(Czochralski)實現大規模製備,也可通過邊界成形薄膜供料法(EFG)和垂直 Bridgman-Stockbarger法生長,具備顯著的工業化潛力。
這與其他寬禁帶半導體形成鮮明對比。除碳化硅(SiC)外,大多數新興寬禁帶半導體缺乏同質襯底,只能在異質材料(硅、碳化硅、藍寶石)上外延,造成晶格失配與大量缺陷,影響器件性能。而Ga₂O₃能自支撐生長,無晶格失配問題。
在物理特性方面,β-Ga₂O₃的帶隙約 4.8 eV,擊穿電場達 8 MV/cm,遠超 Si(1.1 eV, 0.3 MV/cm)、SiC(3.3 eV, 2.5 MV/cm)與 GaN(3.4 eV, 3.3 MV/cm);Baliga 優值(BFOM) 約為 SiC 的 10 倍、GaN 的 4 倍,可實現更低導通電阻與更高能效;窄吸收邊(260 nm),載流子濃度對紫外透過率影響極小,在深紫外光電器件(DUV)中表現出獨特優勢;具備優異的熱穩定性與化學穩定性。依託這些特性,β-Ga₂O₃被視為未來高壓功率器件與深紫外光電應用的理想材料。
當然,它也並非完美。β-Ga₂O₃的主要短板是導熱性低——約為SiC的十分之一,熱量易在器件內部積聚。如何解決散熱瓶頸,成為未來產業化能否突破的關鍵議題。

圖4:β-Ga₂O₃的物理特性及功率晶體管基準圖
(圖源:鎵仁半導體)
更難能可貴的是,氧化鎵可在外延生長或離子注入過程中摻雜,且兼容標準的商用光刻與半導體工藝。這意味着它能複用現有的晶圓製造技術,輕鬆定義納米級尺寸器件。而多數寬禁帶材料不具此優點,甚至 GaN 也不完全具備。
日本在氧化鎵研究上的積累可謂深厚。早在2012年,東京 NICT(日本信息通信研究院) 的 Masataka Higashiwaki 教授就發表了全球首個單晶 β-Ga₂O₃ 晶體管(金屬–半導體場效應管,MESFET),其擊穿電壓超過 250V——要知道,GaN達到同水平耗時近二十年。這項研究首次驗證了β-Ga₂O₃在高壓功率開關器件中的巨大潛力。
這一成果的產業化接力者,是成立於2015年的 Novel Crystal Technology(NCT)。
NCT 致力於氧化鎵材料與器件研發,並持續刷新全球性能紀錄。
2025年4月,NCT宣佈,成功開發出一款垂直結構氧化鎵 MOS 晶體管(β-Ga₂O₃ MOSFET),其功率品質因數(PFOM)達到 1.23 GW/cm²,創下目前全球β-Ga₂O₃ 場效應晶體管的最高紀錄。該指標比此前其他研究機構公布的最高值提升 3.2 倍。該成果預計將大幅推動 0.6–10 kV中高壓氧化鎵晶體管的發展。NCT 計劃進一步採用 NiO 等 p 型異質半導體材料改進終端結構,以進一步降低電極終端電場集中。研究團隊的目標是充分發揮β-Ga₂O₃ 的高擊穿場(6–8 MV/cm)潛力,開發出性能超越 SiC 的新一代高壓功率晶體管。
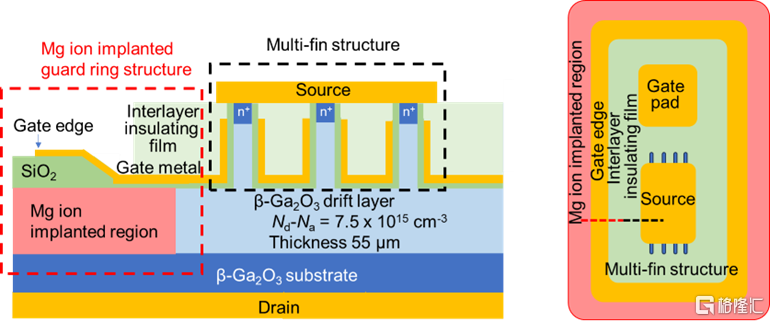
β-Ga₂O₃MOSFET 結構示意圖(a)剖面圖 (b)俯視圖(圖源:NCT)
今年8月1日,NCT還宣佈與另一家在外延生長技術(特別是 HVPE 工藝)方面積累深厚的美國氧化鎵產生Kyma Technologies達成戰略合作,聯合開發150 mm(6 英寸)大面積氧化鎵外延晶圓的製備工藝,用於多千伏級功率器件的研發與製造。
憑藉十餘年的研究積累與材料工藝優勢,日本團隊在氧化鎵領域形成了完整的技術體系——從晶體生長、外延技術到器件結構設計,均處於全球領先水平。
氧化鎵:中國廠商領跑8英寸時代
但是國內氧化鎵產業也不甘示弱,過去三年,國內企業在單晶襯底、外延生長與裝備製造等多個環節接連取得突破。
在氧化鎵材料最上游的單晶襯底環節,國內的杭州鎵仁半導體的進展尤為引人注目。
2025 年 3 月,公司宣佈推出全球首塊 8 英寸β-Ga₂O₃ 單晶,成為全球首家掌握該尺寸生長技術的企業。鎵仁採用由中國科學院院士、浙江大學楊德仁教授團隊自主研發的 鑄錠法(Casting Method)——一種創新型熔融生長技術,具備高效率、低成本、流程簡潔與可擴展性強等優勢。
這一突破不僅打破了全球氧化鎵單晶直徑紀錄,也標誌着公司在短短三年間實現了「從 2 英寸到 8 英寸,每年一代」的跨越式發展。8 英寸β-Ga₂O₃ 襯底與現有 8 英寸硅產線完全兼容,將大幅加快產業化步伐;更大尺寸襯底也有助於提升材料利用率、降低成本、提高製造效率。中國率先進入β-Ga₂O₃ 的 8 英寸時代,具有深遠的戰略意義。

(圖源:公司官網)
杭州鎵仁半導體成立於2022 年9 月,坐落於杭州市蕭山區。公司依託浙江大學硅材料國家重點實驗室與「浙大—杭州全球科技創新中心」,由中國科學院院士楊德仁擔任首席顧問,組建了一支具備自主創新能力的研發與生產團隊。公司開創了氧化鎵單晶生長新技術,擁有國際、國內發明專利十餘項,突破了美國、德國、日本等西方國家在氧化鎵襯底材料上的壟斷和封鎖。
在單晶襯底方面,鎵仁半導體在2025年2月,成功製備出 6 英寸斜切型氧化鎵β-Ga2O3襯底,該襯底的主晶面為 (100) 面,沿 [00-1] 方向傾斜 4°68,如下圖所示。目前,6 英寸β-Ga2O3襯底已實現量產並交付客戶使用。

鎵仁半導體開發的6英寸斜切型氧化鎵(β-Ga2O₃)襯底(圖源:公司官網)
此外,鎵仁還開放了自主研發的垂直 Bridgman(VB)生長系統及配套工藝包。該系統於 2024 年 9 月推出,可在高溫高氧環境下實現 β-Ga₂O₃ 晶體的全自動生長,顯著降低人工干預、提升晶體質量。設備支持多晶面取向與大尺寸製備,滿足高校、科研機構及企業客戶在 β-Ga₂O₃ 研究與生產中的多元需求。
在氧化鎵外延領域,初創企業鎵創未來(成立於 2025 年 7 月)也在快速崛起。據 36Kr 報道,該公司於 2025 年 11 月獲得千萬級天使輪孖展,專注於氧化鎵外延片的研發與產業化,已具備小批量異質外延生產能力。團隊核心成員均為微電子學與固體電子學博士,自 2015 年起深耕寬禁帶材料與器件研發,擁有近十年經驗。
創始人坦言,氧化鎵產業長期受制於襯底成本高、外延供應不足與材料性能限制。目前國產 2 英寸氧化鎵襯底仍需使用高成本的銥坩堝,價格約 2 萬元/片,相當於同尺寸 SiC 襯底的 40 倍,嚴重製約產業化。為此,鎵創未來選擇了兩條關鍵突破路徑:異質外延技術路線——在碳化硅、藍寶石、硅等成熟襯底上生長氧化鎵,將材料成本降低 10 倍以上;自主研發 HVPE 設備——實現大尺寸、厚膜與高遷移率,同時在寬摻雜範圍內取得關鍵性能突破,確保異質外延片穩定量產。
公司重點聚焦兩大高價值應用方向:1)功率器件端,新能源汽車 800V 以上高壓平台、車載充電器、快充樁及 AI 數據中心工業電源;2)光電器件端,日盲紫外探測、深紫外光源及光通信器件等。
國內涉足氧化鎵的企業還有銘鎵半導體(2英寸單晶和外延片)、深圳進化半導體(襯底)、北京鎵族科技(襯底)、杭州富加鎵業(2-4英寸單晶襯底和外延片)、蘇州鎵和(單晶襯底和外延)、蘇州鎵耀(國內首台量產型氧化鎵MOCVD設備)等。總體來看,中國已在氧化鎵的材料、外延與裝備三個關鍵環節上完成從「0到1」的技術自立,正在邁向「從1到N的產業化擴展」。
寫在最後
可以預見,超寬禁帶氧化物正成為功率半導體的下一個主戰場。無論是Patentix推動的「r-GeO₂+Minimal Fab」新體系,還是中日廠商圍繞β-Ga₂O₃ 的產業化競速,都預示着一個全新的材料時代正在開啓。
尤其是β-Ga₂O₃ ,雖然仍面臨導熱性不足、成本偏高以及p型摻雜尚未解決等挑戰,但它已成為最接近商業化的 UWBG 材料之一,並在高壓功率器件市場展現出極強的可替代潛力。氧化鎵的全球競爭格局正逐漸成形:日本憑藉技術積累領跑上游,而中國則以產業化速度強勢突圍。中國在第三代半導體 SiC 領域已構築明顯優勢,那麼,這一優勢能否順延至以Ga₂O₃為代表的下一代材料?讓我們拭目以待。
*免責聲明:本文由作者原創。文章內容系作者個人觀點,半導體行業觀察轉載僅為了傳達一種不同的觀點,不代表半導體行業觀察對該觀讚好同或支持,如果有任何異議,歡迎聯繫半導體行業觀察。