在功率半导体材料的进化谱系中,硅(Si)走到了尽头,碳化硅(SiC)正当红,而氮化镓(GaN)则在高频轻载领域攻城略地。然而,行业对更好的材料的追求是无止尽的。
11月初,日本Patentix株式会社宣布全球首次利用FZ法成功生长出金红石型二氧化锗(r-GeO2)块体晶体——尺寸达到5毫米。这块小小的晶体,带隙高达4.68 eV——远超碳化硅(3.3 eV)和氮化镓(3.4 eV),并且理论上可同时实现p型与n型掺杂。
这一突破,再次将超宽禁带(UWBG)氧化物材料体系推向前台。随着电动汽车(EV)的普及、AI 数据中心的能耗增长、减碳与节能需求的增强,以及车载功率模块小型化趋势的到来,超宽禁带半导体的商业化正受到高度期待。而氧化物,如GeO2和Ga₂O₃,正被视为实现更高耐压、更高功率、更高效率的下一代功率半导体器件的重要候选材料。
二氧化锗:UWBG赛道新黑马?
在超宽禁带(Ultra-Wide Bandgap, UWBG)半导体领域,除了广为人知的氧化镓(Ga₂O₃),二氧化锗(GeO2)正迅速崭露头角,成为新一代功率半导体的竞争者。
二氧化锗作为功率半导体的优势主要有三点:其一,它是具有高功率半导体潜力的超宽带隙半导体;其二,它适用于常规型GeO2 MOSFET的P型和N型掺杂;其三,它拥有廉价的块状晶体和外延层。

二氧化锗的定位(图源:Patentix)
二氧化锗(GeO2)共有五种晶体结构:金红石型、α-石英型、CaCl2型、α-PbO2型和黄铁矿型。日本公司Patentix目前取得突破的就是金红石型二氧化锗(r-GeO2),r-GeO2具有4.6 eV的巨大带隙,理论预测其同时具有n型和p型导电特性。因此,它有望应用于下一代高性能常关型MOSFET等领域。
Patentix 株式会社是一家源自立命馆大学的初创企业,专注于超宽带隙(Ultra-Wide Bandgap, UWBG)半导体材料——二氧化锗(GeO2)的研究开发、制造与销售。自2022 年12月成立以来,公司累计融资额已达10.59亿日元。
为了最大限度地发挥r-GeO2的潜力,需要实现具有最小晶体缺陷的高质量块状衬底。此前该公司曾使用助熔剂法 (Flux Method) 合成块状晶体,最大尺寸约为15x2.5x5mm]。为了利用r-GeO2实现功率半导体器件,更高质量和更大尺寸的块状晶体是必需的。
此次Patentix以传统熔剂法合成的r-GeO2块体晶体作为种晶,Patentix成功实现了全球首例通过FZ法生长的 r-GeO2晶体。如图 1所示,晶体左侧的黑色部分为 FZ 法生长区域,尺寸约为 5 mm。虽然晶体因掺杂添加物而呈现黑色,但其侧面可观察到明显的晶面(facets),显示出较高的晶体质量。

图1:采用FZ法生长的r-GeO₂块体晶体照片。左侧的黑色部分为通过 FZ 法生长的晶体,右侧的白色部分为采用熔剂法(Flux 法)合成的种晶。(图源:Patentix)
通过 X 射线衍射(XRD)对侧面晶面进行分析,确认其对应 r-GeO2的 (110) 晶面(见图 2)。进一步将生长部分研磨成粉末后进行 XRD测试,观察到 r-GeO2的晶峰;但同时也检测到三方晶系(trigonal)GeO2的衍射峰,说明生长晶体中仍含有与金红石型不同的杂相(见图 3)。

图2:晶体侧面晶面的 X 射线 2θ/θ 衍射图谱。
(图源:Patentix)

图3:将晶体粉末化后获得的 X 射线 2θ/θ 衍射图谱。(图源:Patentix)
该公司接下来的目标是制备出半英寸级的 r-GeO2块体衬底,更长远的计划是,结合半英寸 r-GeO2块体衬底与Minimal Fab系统,开发出传统半导体材料无法实现的超高性能功率器件。
除了金红石型GeO2,另一方面,三角晶系α-石英型GeO2具有6.2 eV的超大带隙,并表现出压电性。因此,它有望作为HEMT元件应用于下一代肖特基势垒二极管以及6G之后的高容量、高速7G通信。
氧化镓,日本技术积累颇深
接下来让我们再来看看看从前几年就开始被业界追捧的氧化镓(Ga₂O₃),被视为继SiC与GaN之后最具潜力的高压功率器件材料。它是一种性能远超氮化镓的无机化合物,目前已知晶相多达六种,其中包括α、β、γ等五种稳定相与一个瞬态相κ-Ga₂O₃。其中,β相(β-Ga₂O₃)是热力学最稳定、研究最深入的晶体结构,也是当下产业化的主角。
β-Ga₂O₃的研究最早可以追溯至日本筑波材料科学研究所(NIMS)与德国柏林 Leibniz 晶体研究所的合作阶段。这种材料熔点高达 1793℃,在高温下其他相都会转变为 β 型,因此只能通过熔体法获得单晶。得益于优异的热稳定性,β-Ga₂O₃可采用与硅晶圆相似的 直拉法(Czochralski)实现大规模制备,也可通过边界成形薄膜供料法(EFG)和垂直 Bridgman-Stockbarger法生长,具备显著的工业化潜力。
这与其他宽禁带半导体形成鲜明对比。除碳化硅(SiC)外,大多数新兴宽禁带半导体缺乏同质衬底,只能在异质材料(硅、碳化硅、蓝宝石)上外延,造成晶格失配与大量缺陷,影响器件性能。而Ga₂O₃能自支撑生长,无晶格失配问题。
在物理特性方面,β-Ga₂O₃的带隙约 4.8 eV,击穿电场达 8 MV/cm,远超 Si(1.1 eV, 0.3 MV/cm)、SiC(3.3 eV, 2.5 MV/cm)与 GaN(3.4 eV, 3.3 MV/cm);Baliga 优值(BFOM) 约为 SiC 的 10 倍、GaN 的 4 倍,可实现更低导通电阻与更高能效;窄吸收边(260 nm),载流子浓度对紫外透过率影响极小,在深紫外光电器件(DUV)中表现出独特优势;具备优异的热稳定性与化学稳定性。依托这些特性,β-Ga₂O₃被视为未来高压功率器件与深紫外光电应用的理想材料。
当然,它也并非完美。β-Ga₂O₃的主要短板是导热性低——约为SiC的十分之一,热量易在器件内部积聚。如何解决散热瓶颈,成为未来产业化能否突破的关键议题。

图4:β-Ga₂O₃的物理特性及功率晶体管基准图
(图源:镓仁半导体)
更难能可贵的是,氧化镓可在外延生长或离子注入过程中掺杂,且兼容标准的商用光刻与半导体工艺。这意味着它能复用现有的晶圆制造技术,轻松定义纳米级尺寸器件。而多数宽禁带材料不具此优点,甚至 GaN 也不完全具备。
日本在氧化镓研究上的积累可谓深厚。早在2012年,东京 NICT(日本信息通信研究院) 的 Masataka Higashiwaki 教授就发表了全球首个单晶 β-Ga₂O₃ 晶体管(金属–半导体场效应管,MESFET),其击穿电压超过 250V——要知道,GaN达到同水平耗时近二十年。这项研究首次验证了β-Ga₂O₃在高压功率开关器件中的巨大潜力。
这一成果的产业化接力者,是成立于2015年的 Novel Crystal Technology(NCT)。
NCT 致力于氧化镓材料与器件研发,并持续刷新全球性能纪录。
2025年4月,NCT宣布,成功开发出一款垂直结构氧化镓 MOS 晶体管(β-Ga₂O₃ MOSFET),其功率品质因数(PFOM)达到 1.23 GW/cm²,创下目前全球β-Ga₂O₃ 场效应晶体管的最高纪录。该指标比此前其他研究机构公布的最高值提升 3.2 倍。该成果预计将大幅推动 0.6–10 kV中高压氧化镓晶体管的发展。NCT 计划进一步采用 NiO 等 p 型异质半导体材料改进终端结构,以进一步降低电极终端电场集中。研究团队的目标是充分发挥β-Ga₂O₃ 的高击穿场(6–8 MV/cm)潜力,开发出性能超越 SiC 的新一代高压功率晶体管。
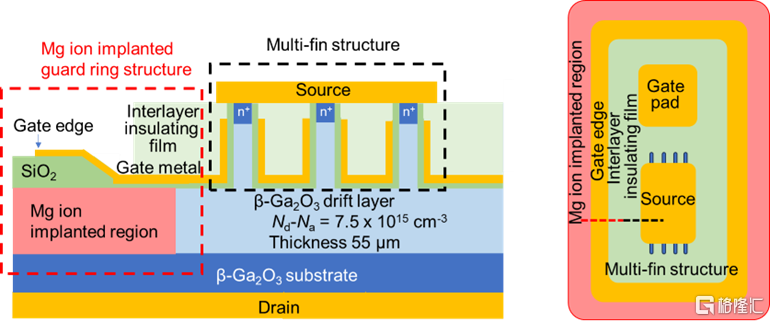
β-Ga₂O₃MOSFET 结构示意图(a)剖面图 (b)俯视图(图源:NCT)
今年8月1日,NCT还宣布与另一家在外延生长技术(特别是 HVPE 工艺)方面积累深厚的美国氧化镓产生Kyma Technologies达成战略合作,联合开发150 mm(6 英寸)大面积氧化镓外延晶圆的制备工艺,用于多千伏级功率器件的研发与制造。
凭借十余年的研究积累与材料工艺优势,日本团队在氧化镓领域形成了完整的技术体系——从晶体生长、外延技术到器件结构设计,均处于全球领先水平。
氧化镓:中国厂商领跑8英寸时代
但是国内氧化镓产业也不甘示弱,过去三年,国内企业在单晶衬底、外延生长与装备制造等多个环节接连取得突破。
在氧化镓材料最上游的单晶衬底环节,国内的杭州镓仁半导体的进展尤为引人注目。
2025 年 3 月,公司宣布推出全球首块 8 英寸β-Ga₂O₃ 单晶,成为全球首家掌握该尺寸生长技术的企业。镓仁采用由中国科学院院士、浙江大学杨德仁教授团队自主研发的 铸锭法(Casting Method)——一种创新型熔融生长技术,具备高效率、低成本、流程简洁与可扩展性强等优势。
这一突破不仅打破了全球氧化镓单晶直径纪录,也标志着公司在短短三年间实现了“从 2 英寸到 8 英寸,每年一代”的跨越式发展。8 英寸β-Ga₂O₃ 衬底与现有 8 英寸硅产线完全兼容,将大幅加快产业化步伐;更大尺寸衬底也有助于提升材料利用率、降低成本、提高制造效率。中国率先进入β-Ga₂O₃ 的 8 英寸时代,具有深远的战略意义。

(图源:公司官网)
杭州镓仁半导体成立于2022 年9 月,坐落于杭州市萧山区。公司依托浙江大学硅材料国家重点实验室与“浙大—杭州全球科技创新中心”,由中国科学院院士杨德仁担任首席顾问,组建了一支具备自主创新能力的研发与生产团队。公司开创了氧化镓单晶生长新技术,拥有国际、国内发明专利十余项,突破了美国、德国、日本等西方国家在氧化镓衬底材料上的垄断和封锁。
在单晶衬底方面,镓仁半导体在2025年2月,成功制备出 6 英寸斜切型氧化镓β-Ga2O3衬底,该衬底的主晶面为 (100) 面,沿 [00-1] 方向倾斜 4°68,如下图所示。目前,6 英寸β-Ga2O3衬底已实现量产并交付客户使用。

镓仁半导体开发的6英寸斜切型氧化镓(β-Ga2O₃)衬底(图源:公司官网)
此外,镓仁还开放了自主研发的垂直 Bridgman(VB)生长系统及配套工艺包。该系统于 2024 年 9 月推出,可在高温高氧环境下实现 β-Ga₂O₃ 晶体的全自动生长,显著降低人工干预、提升晶体质量。设备支持多晶面取向与大尺寸制备,满足高校、科研机构及企业客户在 β-Ga₂O₃ 研究与生产中的多元需求。
在氧化镓外延领域,初创企业镓创未来(成立于 2025 年 7 月)也在快速崛起。据 36Kr 报道,该公司于 2025 年 11 月获得千万级天使轮融资,专注于氧化镓外延片的研发与产业化,已具备小批量异质外延生产能力。团队核心成员均为微电子学与固体电子学博士,自 2015 年起深耕宽禁带材料与器件研发,拥有近十年经验。
创始人坦言,氧化镓产业长期受制于衬底成本高、外延供应不足与材料性能限制。目前国产 2 英寸氧化镓衬底仍需使用高成本的铱坩埚,价格约 2 万元/片,相当于同尺寸 SiC 衬底的 40 倍,严重制约产业化。为此,镓创未来选择了两条关键突破路径:异质外延技术路线——在碳化硅、蓝宝石、硅等成熟衬底上生长氧化镓,将材料成本降低 10 倍以上;自主研发 HVPE 设备——实现大尺寸、厚膜与高迁移率,同时在宽掺杂范围内取得关键性能突破,确保异质外延片稳定量产。
公司重点聚焦两大高价值应用方向:1)功率器件端,新能源汽车 800V 以上高压平台、车载充电器、快充桩及 AI 数据中心工业电源;2)光电器件端,日盲紫外探测、深紫外光源及光通信器件等。
国内涉足氧化镓的企业还有铭镓半导体(2英寸单晶和外延片)、深圳进化半导体(衬底)、北京镓族科技(衬底)、杭州富加镓业(2-4英寸单晶衬底和外延片)、苏州镓和(单晶衬底和外延)、苏州镓耀(国内首台量产型氧化镓MOCVD设备)等。总体来看,中国已在氧化镓的材料、外延与装备三个关键环节上完成从“0到1”的技术自立,正在迈向“从1到N的产业化扩展”。
写在最后
可以预见,超宽禁带氧化物正成为功率半导体的下一个主战场。无论是Patentix推动的“r-GeO₂+Minimal Fab”新体系,还是中日厂商围绕β-Ga₂O₃ 的产业化竞速,都预示着一个全新的材料时代正在开启。
尤其是β-Ga₂O₃ ,虽然仍面临导热性不足、成本偏高以及p型掺杂尚未解决等挑战,但它已成为最接近商业化的 UWBG 材料之一,并在高压功率器件市场展现出极强的可替代潜力。氧化镓的全球竞争格局正逐渐成形:日本凭借技术积累领跑上游,而中国则以产业化速度强势突围。中国在第三代半导体 SiC 领域已构筑明显优势,那么,这一优势能否顺延至以Ga₂O₃为代表的下一代材料?让我们拭目以待。
*免责声明:本文由作者原创。文章内容系作者个人观点,半导体行业观察转载仅为了传达一种不同的观点,不代表半导体行业观察对该观点赞同或支持,如果有任何异议,欢迎联系半导体行业观察。